Nitrure de gallium-indium
| Nitrure de gallium-indium | |

| |
| __ Ga3+/In3+ __ N3- | |
| Identification | |
|---|---|
| Nom UICPA | Nitrure de gallium-indium |
| Propriétés chimiques | |
| Formule | InxGa1-xN |
| Propriétés électroniques | |
| Bande interdite | 3,4 eV (x = 0) à 0,67 eV (x = 1) |
| Unités du SI et CNTP, sauf indication contraire. | |
| modifier |
|
Le Nitrure de gallium-indium (InGaN, InxGa1-xN) est un semi-conducteur III-V composé de nitrure de gallium (GaN) et de nitrure d'indium (InN).
C'est un composé à gap direct, dont la bande interdite peut varier théoriquement entre 0,67 et 3,4 eV, en fonction du ratio In/Ga. Ce ratio ne varie cependant en pratique qu'entre 0,02/0,98 et 0,3/0,7[1].
Applications[modifier | modifier le code]
LED[modifier | modifier le code]

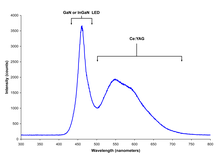
Le nitrure d'indium et de gallium est la couche émettrice de lumière dans les LED bleues et vertes modernes qui est souvent implantée sur une couche tampon de GaN sur un substrat transparent comme, par exemple, le saphir ou le carbure de silicium. Il a une capacité thermique élevée et sa sensibilité aux rayonnements ionisants est faible (comme les autres nitrures du groupe III), ce qui en fait également un matériau potentiellement approprié pour les dispositifs solaires photovoltaïques, en particulier pour les panneaux de satellites.
Il est théoriquement prédit que la décomposition spinodale du nitrure d’indium devrait se produire pour des compositions comprises entre 15 % et 85 %, conduisant à des régions ou des amas d'InGaN riches en In et riches en Ga. Cependant, seule une faible ségrégation de phase a été observée dans les études expérimentales de structure locale[2]. D’autres résultats expérimentaux utilisant la cathodoluminescence et l'excitation par photoluminescence sur des puits multi-quantiques InGaN à faible teneur en In ont démontré qu'en fournissant les paramètres matériels corrects des alliages InGaN/GaN, les approches théoriques pour les systèmes AlGaN/GaN s'appliquent également aux nanostructures InGaN[3].
Le GaN est un matériau riche en défauts avec des densités de dislocation typiques supérieures à 108 cm−2[4]. On s’attend à ce que l'émission de lumière provenant des couches d'InGaN cultivées sur des tampons de GaN utilisés dans les LED bleues et vertes soit atténuée en raison de la recombinaison non radiative sur ces défauts[5]. Néanmoins, les puits quantiques en InGaN sont des émetteurs de lumière efficaces dans les diodes électroluminescentes vertes, bleues, blanches et ultraviolettes et les diodes laser[6],[7],[8]. Les régions riches en indium ont une bande interdite inférieure à celle du matériau environnant et créent des régions d’énergie potentielle réduite pour les porteurs de charge. Les paires électron-trou y sont piégées et se recombinent avec émission de lumière, au lieu de se diffuser vers des défauts cristallins où la recombinaison n’est pas radiative. De plus, des simulations informatiques auto-cohérentes ont montré que la recombinaison radiative est concentrée là où les régions sont riches en indium[9].
La longueur d’onde émise, qui dépend de la bande interdite du matériau, peut être contrôlée par le rapport GaN/InN : proche ultraviolet pour 0,02 In/0,98 Ga, 390 nm pour 0,1 In/0,9 Ga, violet-bleu à 420 nm pour 0,2 In/0,8 Ga, bleu à 440 nm pour 0,3 In/0,7 Ga, rouge pour des rapports plus élevés, aussi que par l'épaisseur des couches d'InGaN qui sont généralement de l’ordre de 2 à 3 nm. Cependant, les résultats des simulations atomiques ont montré que les énergies d’émission dépendent peu des petites variations des dimensions des dispositifs[10]. Des études basées sur la simulation de dispositifs ont montré qu’il pourrait être possible d’augmenter l’efficacité des LED InGaN/GaN en utilisant l'ingénierie de la bande interdite, en particulier pour les LED vertes[11].
Photovoltaïque[modifier | modifier le code]
La possibilité d’effectuer une ingénierie de bande interdite avec InGaN sur une plage qui fournit une bonne correspondance spectrale avec la lumière du soleil, rend l'InGaN adapté aux cellules photovoltaïques[12],[13]. Il est possible de faire croître plusieurs couches avec des bandes interdites différentes, car le matériau est relativement insensible aux défauts introduits par un désaccord de réseau entre les couches. Une cellule multijonction à deux couches avec des bandes interdites de 1,1 eV et 1,7 eV peut atteindre une efficacité maximale théorique de 50 %, et en déposant plusieurs couches accordées sur une large plage de bande interdite, une efficacité allant jusqu’à 70 % est théoriquement attendue[14].
Une photoréponse significative a été obtenue à partir de dispositifs expérimentaux InGaN à jonction unique[15],[16]. En plus de contrôler les propriétés optiques[17], ce qui entraîne une ingénierie de bande interdite, les performances des dispositifs photovoltaïques peuvent être améliorées en modifiant la microstructure du matériau pour augmenter la longueur du chemin optique et fournir un piégeage de la lumière. La croissance de nanocolonnes sur le dispositif peut en outre entraîner une interaction de résonance avec la lumière[18], et des nanocolonnes d’InGaN ont été déposées avec succès sur SiO2 à l’aide d’une évaporation améliorée par plasma[19]. La croissance des nanotiges peut également être avantageuse dans la réduction des dislocations de marche qui peuvent agir comme des pièges à charge réduisant l’efficacité des cellules solaires[20].
L’épitaxie modulée par les métaux permet une croissance atomique contrôlée couche par couche de couches minces avec des caractéristiques presque idéales rendues possibles par la relaxation de la déformation au niveau de la première couche atomique. Les structures du réseau cristallin correspondent, ressemblant à un cristal parfait, avec la luminosité correspondante. Le cristal avait une teneur en indium allant de x ~ 0,22 à 0,67. L’amélioration significative de la qualité cristalline et des propriétés optiques a commencé à x ~ 0,6. Les films ont été fabriqués à ~400 °C pour faciliter l’incorporation de l’indium et avec une modulation des précurseurs pour améliorer la morphologie de surface et la diffusion de l’adlayer métallique. Ces résultats devraient contribuer au développement de techniques de croissance pour les semi-conducteurs nitrurés dans des conditions d'inadaptation élevée du réseau[21],[22].
Notes et références[modifier | modifier le code]
- (en) Cet article est partiellement ou en totalité issu de l’article de Wikipédia en anglais intitulé « Indium gallium nitride » (voir la liste des auteurs).
- (en) G. Linti, The Group13 Metals Aluminium, Gallium, Indium and Thallium. Chemical Patterns and Peculiarities, Simon Aldridge and AnthonyJ. Downs.Angew. Chem (DOI 10.1002/anie.201105633)
- (en) V. Kachkanov, K.P. O'Donnell, S. Pereira et R.W. Martin, « Localization of excitation in InGaN epilayers », Phil. Mag., vol. 87, no 13, , p. 1999–2017 (DOI 10.1080/14786430701342164, Bibcode 2007PMag...87.1999K, S2CID 136950050, lire en ligne)
- (en) A. Reale, A. Di Carlo, A. Vinattieri, M. Colocci, F. Rossi, N. Armani, C. Ferrari, G. Salviati, L. Lazzarini et V. Grillo, « Investigation of the recombination dynamics in low In-content InGaN MQWs by means of cathodoluminescence and photoluminescence excitation », Physica Status Solidi C, vol. 2, no 2, , p. 817–821 (DOI 10.1002/pssc.200460305, Bibcode 2005PSSCR...2..817R)
- (en) Rak Jun Choi, Hyung Jae Lee, Yoon-bong Hahn et Hyung Koun Cho, « Structural and optical properties of InGaN/GaN triangular-shape quantum wells with different threading dislocation densities », Korean Journal of Chemical Engineering, vol. 21, , p. 292–295 (DOI 10.1007/BF02705411, S2CID 54212942)
- (en) P. G. Eliseev, « Radiative processes in InGaN quantum wells » [archive du ]
- (en) Liang-Yi Chen, Ying-Yuan Huang, Chun-Hsiang Chang, Yu-Hsuan Sun, Yun-Wei Cheng, Min-Yung Ke, Cheng-Pin Chen et JianJang Huang, « High performance InGaN/GaN nanorod light emitting diode arrays fabricated by nanosphere lithography and chemical mechanical polishing processes », Optics Express, vol. 18, no 8, , p. 7664–7669 (PMID 20588606, DOI 10.1364/OE.18.007664
 , Bibcode 2010OExpr..18.7664C)
, Bibcode 2010OExpr..18.7664C)
- (en) HJ Chang et al., « Strong luminescence from strain relaxed InGaN/GaN nanotips for highly efficient light emitters » (consulté le )
- (en) C Skierbiszewski, P Perlin, I Grzegory, Z R Wasilewski, M Siekacz, A Feduniewicz, P Wisniewski, J Borysiuk, P Prystawko, G Kamler, T Suski and S Porowski, « High power blue–violet InGaN laser diodes grown on bulk GaN substrates by plasma-assisted molecular beam epitaxy », Semiconductor Science and Technology, vol. 20, no 8, , p. 809–813 (DOI 10.1088/0268-1242/20/8/030, Bibcode 2005SeScT..20..809S, S2CID 97464128)
- (en) F. Sacconi, M. Auf der Maur, A. Pecchia, M. Lopez et A. Di Carlo, « Optoelectronic properties of nanocolumnar InGaN/GaN quantum disk LEDs », Physica Status Solidi C, vol. 9, no 5, , p. 1315–1319 (DOI 10.1002/pssc.201100205
 , Bibcode 2012PSSCR...9.1315S)
, Bibcode 2012PSSCR...9.1315S)
- (en) M. Lopez, F. Sacconi, M. Auf der Maur, A. Pecchia, A. Di Carlo, « Atomistic simulation of InGaN/GaN quantum disk LEDs », Optical and Quantum Electronics, vol. 44, no 3, , p. 89–94 (DOI 10.1007/s11082-012-9554-3, S2CID 126339984)
- (en) M. Auf der Maur, K. Lorenz and A. Di Carlo, « Band gap engineering approaches to increase InGaN/GaN LED efficiency », Physica Status Solidi C, vol. 44, nos 3–5, , p. 83–88 (DOI 10.1007/s11082-011-9536-x, S2CID 11753092)
- (en) D.V.P. McLaughlin et J.M. Pearce, « Progress in Indium Gallium Nitride Materials for Solar Photovoltaic Energy Conversion », Metallurgical and Materials Transactions A, vol. 44, no 4, , p. 1947–1954 (DOI 10.1007/s11661-013-1622-1, Bibcode 2013MMTA...44.1947M, S2CID 13952749, lire en ligne)
- (en) A. Bhuiyan, K. Sugita, A. Hashimoto et A. Yamamoto, « InGaN Solar Cells: Present State of the Art and Important Challenges », IEEE Journal of Photovoltaics, vol. 2, no 3, , p. 276–293 (DOI 10.1109/JPHOTOV.2012.2193384, S2CID 22027530)
- A nearly perfect solar cell, part 2 « https://web.archive.org/web/20200917000213/https://www2.lbl.gov/Science-Articles/Archive/MSD-perfect-solar-cell-2.html »(Archive.org • Wikiwix • Archive.is • Google • Que faire ?), . Lbl.gov. Retrieved on 2011-11-07.
- (en) S. W. Zeng et al., « Substantial photo-response of InGaN p–i–n homojunction solar cells », Semicond. Sci. Technol., vol. 24, no 5, , p. 055009 (DOI 10.1088/0268-1242/24/5/055009, Bibcode 2009SeScT..24e5009Z, S2CID 97236733)
- (en) X. Sun et al., « Photoelectric characteristics of metal/InGaN/GaN heterojunction structure », J. Phys. D, vol. 41, no 16, , p. 165108 (DOI 10.1088/0022-3727/41/16/165108, Bibcode 2008JPhD...41p5108S, S2CID 120480676)
- (en) Dirk V. P. McLaughlin et J.M. Pearce, « Analytical Model for the Optical Functions of Indium Gallium Nitride with Application to Thin Film Solar Photovoltaic Cells », Materials Science and Engineering: B, vol. 177, no 2, , p. 239–244 (DOI 10.1016/j.mseb.2011.12.008, arXiv 1201.2911, S2CID 95949405)
- (en) L. Cao, J. S. White, J. S. Park, J. A. Schuller, B. M. Clemens et M. L. Brongersma, « Engineering light absorption in semiconductor nanowire devices », Nature Materials, vol. 8, no 8, , p. 643–647 (PMID 19578337, DOI 10.1038/nmat2477, Bibcode 2009NatMa...8..643C)
- (en) S. Keating, M.G. Urquhart, D.V.P. McLaughlin et J.M. Pearce, « Effects of Substrate Temperature on Indium Gallium Nitride Nanocolumn Crystal Growth », Crystal Growth & Design, vol. 11, no 2, , p. 565–568 (DOI 10.1021/cg101450n, arXiv 1203.0645, S2CID 53506014, lire en ligne)
- (en) D. Cherns, R. F. Webster, S. V. Novikov, C. T. Foxon, A. M. Fischer, F. A. Ponce et S. J. Haigh, « Compositional variations in In0.5Ga0.5N nanorods grown by molecular beam epitaxy », Nanotechnology, vol. 25, no 21, , p. 215705 (PMID 24785272, DOI 10.1088/0957-4484/25/21/215705
 , Bibcode 2014Nanot..25u5705C)
, Bibcode 2014Nanot..25u5705C)
- (en) « Controlled atomic-layer crystal growth is 'breakthrough' for solar-cell efficiency », KurzweilAI (consulté le )
- (en) A. M. Fischer, Y. O. Wei, F. A. Ponce, M. Moseley, B. Gunning et W. A. Doolittle, « Highly luminescent, high-indium-content InGaN film with uniform composition and full misfit-strain relaxation », Applied Physics Letters, vol. 103, no 13, , p. 131101 (DOI 10.1063/1.4822122, Bibcode 2013ApPhL.103m1101F, lire en ligne)
